Ohnishi Kazuki大西 一生
- 1994年生まれ
- 2019年3月 東北大学工学研究科 博士課程(前期課程)修了
- 2019年4月 名古屋大学工学研究科 博士課程(後期課程)進学
- 2020年4月 日本学術振興会 特別研究員(DC2)採用

GaN縦型パワーデバイス作製に向けたハライド気相成長技術の確立
赤﨑先生、天野先生が中心となり研究が進んだGaNは青色LED用半導体として社会に広く認知されています。このGaNはパワーデバイスとしても魅力的な物性を有していることから、省エネルギー社会実現に向けた次世代半導体としても注目を浴びています。GaNを用いた高耐圧の縦型パワーデバイスを作製するためには、低ドーピング密度で数十μm以上のドリフト層が必要になります。しかし、結晶成長に使用される有機金属気相成長法では、成長速度が数μm/h程度と遅いことに加え、キャリアを補償する炭素が混入するため、パワーデバイス構造の成長手法としては不向きです。そこで、我々はハライド気相成長(HVPE)法に着目し、HVPE法による高耐圧パワーデバイス作製に向けてその成長手法の確立に取り組んでいます。
GaNのHVPE成長の歴史は非常に古く、1969年に報告されたGaNの最初の結晶成長はHVPE法によって行われました。HVPE法の特徴は、数百μm/hの高い成長速度と炭素を含まず高純度なGaNが成長できる点です。この高い成長速度からGaNは自立基板作製に広く使用されています。このように、HVPE法は魅力的な成長法ですが、パワーデバイス用途へ適用されていません。その大きな理由の1つとして、アクセプタであるMgのドーピング源となる適切な原料が見つかっておらず、HVPE法によるp型GaNが実現されていないことが挙げられます。
私はHVPE法によるp型GaNの実現に向けて、Mg原料としてMgOに着目しました。MgOは蒸気圧が低く、安定性が高いことからMg濃度の安定した制御が期待できます。そこで、加熱したMgOにHClを供給することでMgOとHClを反応させ、生成されるMgCl2を前駆体としたMgドーピングを試みました。その結果、Mg濃度はMgO温度とHCl供給分圧によって制御できることがわかりました。また成長条件を改善することによって、Mgアクセプタによるp型伝導を実現いたしました。図1にHVPE法によって作製されたp型GaNのアクセプタ密度および補償ドナー密度のMg濃度依存性を示します。MgOを原料に用いることによってMg濃度1017~1020cm-3の広い範囲でp型GaNを作製することができました。次に、図2(a)に示すようなp-n接合ダイオードをHVPE法によって作製いたしました。このp-n接合ダイオードの電流-電圧特性を評価したところ、図2(b)に示すように理想的なアバランシェ破壊を有していることが確認できました。以上より、HVPE法は縦型パワーデバイス構造の成長手法として有用であることを示すことができました。
現在は、さらなるデバイス特性の向上に向けて、成長させたGaNの特性評価と結晶成長条件の改善を進めています。本研究を通じて、GaNパワーデバイスの実用化および窒化物半導体分野の発展に貢献を目指します。
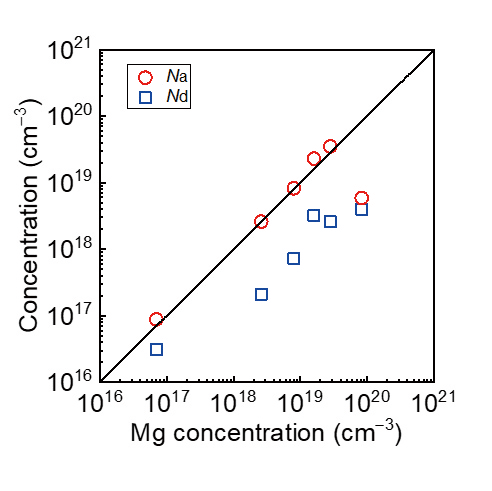
図1 HVPE法によって作製されたp型GaNのアクセプタ密度および補償ドナー密度のMg濃度依存性。
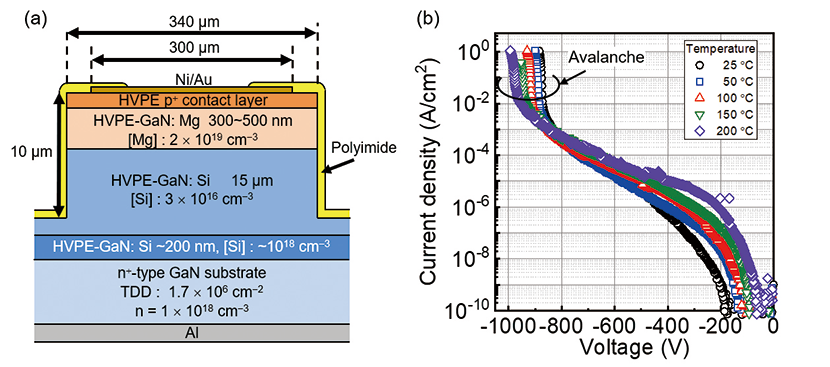
図2 HVPE法によって作製されたp-n接合ダイオード。(a)デバイス構造の模式図および(b)逆方向電流-電圧特性。