Endo Meguru遠藤 彗
- 1996年生まれ
- 2021年3月 名古屋大学工学研究科 博士前期課程修了
- 2021年4月 名古屋大学工学研究科 博士後期課程進学
- 2023年4月 日本学術振興会 特別研究員(DC2)採用

高性能GaNパワーデバイス実現に向けた真性欠陥の評価
脱炭素社会実現のためには、電力変換を行う回路で重要な役割を担う半導体パワーデバイスの性能向上が鍵となります。窒化ガリウム(GaN)は、その優れた物性から次世代半導体パワーデバイス材料として期待され、研究が進められています。
GaNパワーデバイスを作製するためには、結晶成長、エッチング、イオン注入、薄膜堆積など様々な加工プロセスが必要となります。こうしたプロセスでは、GaN結晶中に様々な不純物が導入されるだけでなく、結晶が乱れてGa、N原子が規則正しく配置されない部分も形成されます。このような原子サイズの結晶の乱れ(点欠陥)は、電子が存在できないバンドギャップ中に電子が存在できる深い準位を形成します。深い準位は所望のデバイス構造の作製を困難にする他、デバイス動作に大きな影響を及ぼします。高性能GaNパワーデバイス作製のためには、点欠陥の低減、そして点欠陥を考慮したデバイスシミュレーションによる設計が必要不可欠です。そのためには点欠陥が形成する深い準位の特性について詳細に評価する必要があります。
これまで、鉄や炭素といった結晶成長中に導入される不純物が形成する深い準位については、結晶成長中に意図的に導入した不純物の密度と深い準位の密度を比較することで詳細な評価がなされてきました。一方で、Ga、N原子で構成される点欠陥(真性欠陥)は、不純物のように結晶成長中に意図的に欠陥を導入し、密度を直接測定することは困難です。そこで、我々は電子線照射を利用した欠陥導入方法に着目し、真性欠陥が形成する深い準位の評価に取り組んでいます。
電子線照射では、加速された電子が結晶中の原子をはじき出すため、不純物を導入することなく真性欠陥のみを導入することが可能です。また、軽い原子の方がはじき出されやすいため、適切な電子の加速エネルギーを選択することでN原子のみをはじき出し、N原子の変位に関連した欠陥が形成する深い準位のみを評価することが可能となります。
私はGaN中の真性欠陥が形成する深い準位の特性理解に向けて、GaN pn接合ダイオードに対し電子線照射を用いてN原子変位関連欠陥のみを導入し、p型GaN中に形成される深い準位をDLTS法という測定方法により評価しました。その結果、価電子帯上端から0.52 eV高い位置に深い準位が形成されることがわかりました。この深い準位は、理論計算の結果と比較することでN空孔または格子間Nである可能性が高いことがわかりました。また、少数キャリアである電子をp型層に注入することで、この深い準位が減少し、それに代わって新たな深い準位が形成される現象も見出しました。
現在は、n型GaNを用いて同様の評価を行うだけでなく、窒素原子変位関連欠陥が熱処理によってどのように減少していくのかについて評価を進めています。高性能GaNパワーデバイスの実用化の礎となる、点欠陥の性質、振る舞いの解明をしっかり進めて行きたいと思います。

図1 電子線照射前後のp型GaNに対するDLTS測定の結果
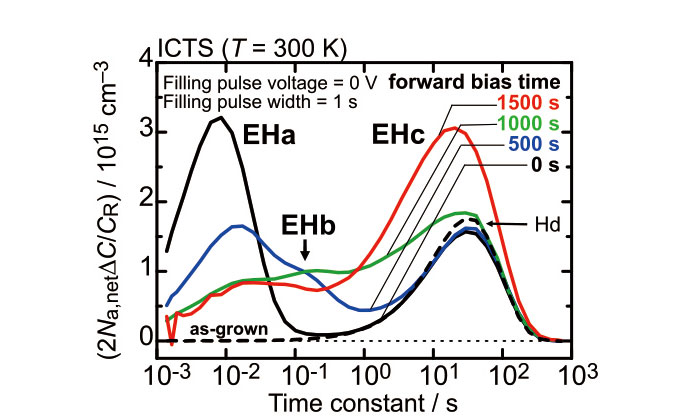
図2 等温DLTSスペクトルの少数キャリア注入時間依存性