SUMIDA Kensuke角田 健輔
- 1999年生まれ
- 2023年3月 名古屋大学工学研究科博士前期課程修了
- 2023年4月 名古屋大学工学研究科博士後期課程進学
- 2024年4月 日本学術振興会特別研究員(DC2)採用

超低損失なGaNパワーデバイス実現に向けたMgイオン注入技術の確立
私は、低損失な半導体パワーデバイスの実現に向けた研究を行っています。半導体パワーデバイスは、電力の制御や変換を担うデバイスであり、新幹線や電気自動車、家電など、あらゆる電力機器に搭載されています。しかし、電力変換の際には電気エネルギーの一部が熱として失われる「電力損失」が避けられません。この損失を低減することは、世界全体の電力消費の削減や脱炭素社会の実現に直結します。
パワーデバイスの低損失化の鍵となるのが、新材料を活用した性能向上です。従来主流であったSi(シリコン)パワーデバイスは、材料物性で決まる理論限界に近づいており、飛躍的な性能向上は難しくなっています。そこで注目されているのが、ワイドバンドギャップ半導体であるGaN(窒化ガリウム)です。理論上GaNはSiに比べてオン抵抗(導通損失)を約1/500に低減可能であり、超低損失なパワーデバイスの実現が期待されています。その中でも、大電流・高耐圧化が可能なGaN縦型パワーデバイスが次世代デバイスとして注目されています。
しかし、GaN縦型パワーデバイスはその作製プロセスにおいていくつかの技術課題を抱えています。最も大きな課題の一つが、Mgイオン注入による局所的なp型ドーピング技術の確立です。Mgイオン注入の確立に向けては、イオン注入後の熱処理中にMgが異常に拡散し、正確なp型領域形成が困難となることが問題となっています。Mgが拡散すると、パワーデバイスの微細な構造形成やp型領域の濃度制御が難しくなり、デバイス設計の自由度が大幅に狭まります。
私はこの課題を解決するため、様々なイオン注入条件とMg拡散の相関を詳細に評価しました。その結果、MgだけでなくNイオンも同時に注入(Nイオン連続注入)することで、熱処理中のMg拡散を効果的に抑制できることを明らかにしました。さらに、エッチング(半導体表面を削る手法)とホール効果測定を組み合わせてp型領域の深さ分布を評価した結果、Nイオン連続注入によってMg拡散が抑制されるだけでなく、表面近傍の欠陥密度が低下し、電気的特性が向上することが明らかになりました。
現在は、より深い領域へのMgイオン注入を可能にするチャネリングイオン注入法に着目し、活性化条件を詳細に検討することで、超低損失なGaN縦型パワーデバイスの実現に貢献したいと考えています。
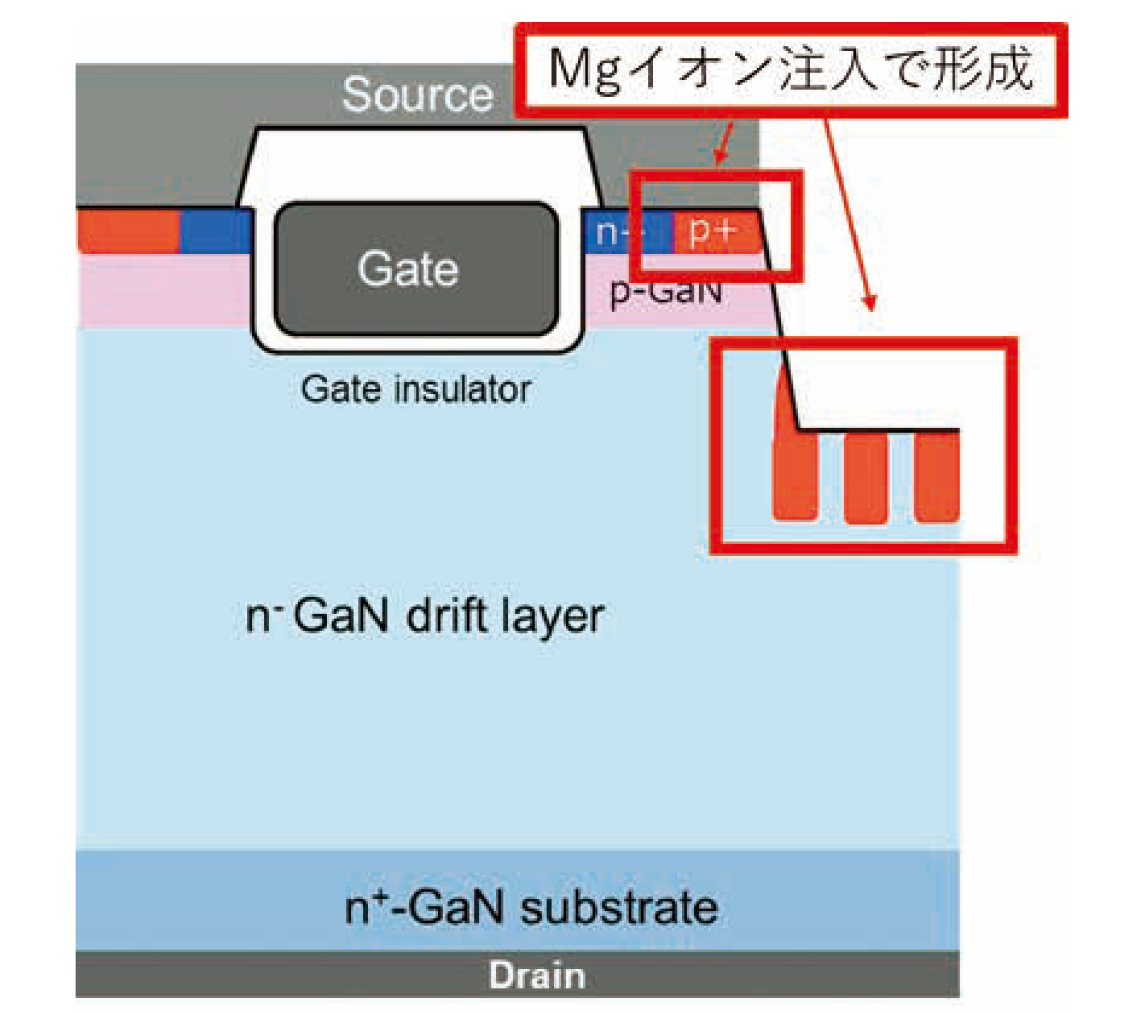
図1 GaN縦型パワーデバイスの構造例
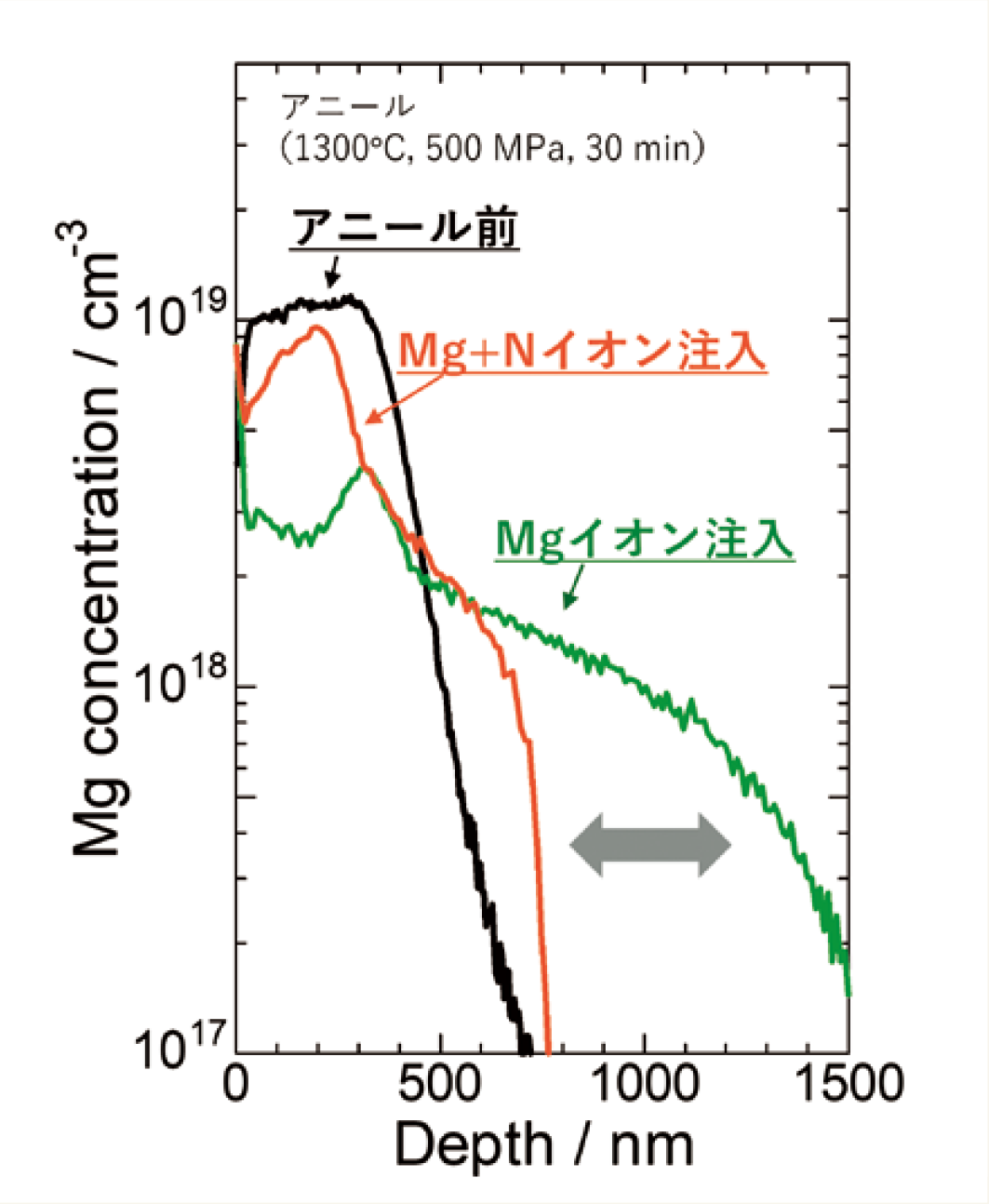
図2 Mgイオン注入およびMg+Nイオン注入GaNのMg深さ分布